Производитель:Fischione Instruments, США
МОДЕЛЬ 1064 ChipMill
Производитель:Fischione Instruments, США
ChipMill для послойного снятия (делейеринга) полупроводниковых устройств логики и памяти в миллиметровом масштабе.
Технические характеристики
|
Источник |
|
|
Загрузочный шлюз (Load lock) |
|
|
Пользовательский интерфейс |
|
|
Равномерность фрезерования |
|
|
Пользовательский интерфейс |
|
|
Автоматическое завершение процесса |
|
|
Столик образца |
|
|
Получение изображений образца |
|
|
Электронно-лучевая колонна |
|
|
Детекторы |
|
|
Процессный газ |
|
|
Управляющий газ |
|
|
Вакуумная система |
|
|
Рабочий газ |
|
|
Контрольный газ |
|
|
Вакуумная система |
|
|
Корпус (Enclosure) |
|
|
Электропитание |
|
|
Гарантия |
|
Расширенное описание
ChipMill
МОДЕЛЬ 1064
Полностью интегрированное решение для послойного удаления (делайеринга) на миллиметровом масштабе как логических, так и запоминающих полупроводниковых устройств. ChipMill объединяет сигналы от нескольких детекторов с помощью алгоритма обратной связи на основе искусственного интеллекта для регулирования параметров ионного травления в режиме реального времени. В результате обеспечивается прецизионное удаление слоёв устройства и формирование высокопланарной поверхности.
• Нанометровая плоскостность подготовленной области
• Площадь обработки (травления) до 10 × 10 мм
• Автоматическое определение высоты образца
• Удобный пользовательский интерфейс для задания параметров ионного травления и отображения изображений и аналитических данных
• Встроенный в прибор сенсорный экран для управления загрузкой и извлечением образцов
• Определение точки окончания процесса по времени, структуре чипа или химическому составу
• Состав системы:
› Ионный источник
› Оптическая камера
› Электронно-лучевая колонна
› Детектор вторичных электронов (SED)
› Детектор обратнорассеянных электронов (BSE)
› Энергодисперсионный рентгеновский спектрометр (EDS)
› Масс-спектрометр вторичных ионов (SIMS)
Революция в пробоподготовке века
Модель 1064 ChipMill — это полностью интегрированное решение для крупномасштабного послойного снятия материала (delayering) — с площадью обработки до 10 × 10 мм — как для запоминающих, так и для логических полупроводниковых устройств. По сравнению со всеми другими методами ChipMill обеспечивает наибольшую плоскостность поверхности на самой большой площади. Система искусственного интеллекта ChipMill автоматически корректирует параметры травления в процессе работы, обеспечивая нанометровую плоскостность в пределах подготовленной области.
ChipMill сокращает время и затраты, связанные с исследованиями и разработкой, производством, контролем качества и анализом отказов, обеспечивая непревзойдённые результаты. По мере роста спроса на полупроводниковые устройства, уменьшения их размеров и усложнения архитектуры возможность выполнять контролируемое послойное удаление материала на всех этапах жизненного цикла продукта становится критически важной.
Компоненты ChipMill
ChipMill включает ионный источник для травления образца, оптическую камеру для мониторинга хода процесса, а также колонну сканирующего электронного микроскопа (SEM), работающую совместно с детектором вторичных электронов (SED) и детектором обратнорассеянных электронов (BSE) для формирования изображений образца.
Электронный пучок также генерирует рентгеновское излучение, которое анализируется энергодисперсионным рентгеновским спектрометром (EDS). Масс-спектрометр вторичных ионов (SIMS) предоставляет информацию о составе поверхности.
Детекторные технологии
Когда поверхность образца возбуждается электронным пучком, соответствующие вторичные электроны собираются детектором вторичных электронов (SED). Электронные изображения отображаются на одном из мониторов ChipMill.
Обратнорассеянные электроны образуются в результате упругого рассеяния первичного электронного пучка на атомных ядрах. Поскольку информация формируется ядром атома, становится доступной информация об элементном составе.
При изменении ускоряющего напряжения электронного пучка изменяется глубина проникновения электронов. ChipMill изменяет рабочие параметры электронного пучка, чтобы различать поверхностный слой и расположенный под ним слой.
Система EDS регистрирует рентгеновское излучение, испускаемое поверхностью образца, обеспечивая определение элементного состава послойно снятого устройства.
Система SIMS определяет элементный состав верхнего слоя устройства.
Роль электронной микроскопии в полупроводниках
Электронная микроскопия используется для поддержки всех этапов жизненного цикла полупроводников: исследований и разработок, производства, контроля качества и анализа отказов.
В частности:
- Исследования и разработки – разрабатываются и проверяются схемы;
- Производство – совершенствуются процессы для повышения производительности и выхода годных изделий;
- Контроль качества – оценивается надежность микросхем;
- Анализ отказов – выявляются и исследуются дефекты.
Микросхемы состоят из нескольких слоев, каждый из которых имеет толщину от нескольких атомных слоев до нескольких микрон, при размерах узлов 3 нм и меньше. Потребность в точном и контролируемом послойном снятии материала никогда не была столь критичной для поддержки роли электронной микроскопии в понимании свойств материалов и химического состава на атомном уровне.
Дополнительные методы, обеспечиваемые точным послойным снятием материала:
- Электрическое зондирование для тестирования отдельных цепей;
- Метрология для измерения размеров элементов с целью обеспечения соответствия проектным спецификациям;
- Постмортем-анализ отдельных дефектов для снятия материала до обнаружения места неисправности;
- Обратная разработка (reverse engineering) для последовательного послойного анализа микросхемы с последующим изучением отдельных слоев.

Компоненты ChipMill
Детекторы и дополнительные компоненты установлены на камере ChipMill.
По часовой стрелке, начиная сверху:
- электронная колонка;
- энергодисперсионный рентгеновский спектрометр (EDS);
- детектор вторичных электронов (SED);
- масс-спектрометр вторичных ионов (SIMS);
- загрузочный шлюз (load lock);
- ионный источник;
- детектор обратно рассеянных электронов (BSE) и оптическая камера.
Рабочий процесс делайеринга (Delayering workflow)
Депакинг (Depackaging)
Перед обработкой в ChipMill применяются стандартные методы депакинга. Эти методы обычно используют механические или химические процессы, которые более подходят для удаления значительных объемов материала по сравнению с точным истончением, обеспечиваемым ионным пучком.
ChipMilling
После того как чип депакован и установлен на стандартный держатель для СЭМ (SEM stub), он переносится через загрузочный шлюз (load lock) ChipMill и позиционируется на образцовой платформе внутри вакуумной камеры.
После начальной настройки чип подвергается ионной обработке до достижения заранее определенной конечной точки. Во многих случаях конечной точкой является отдельный металлический слой. После ChipMilling чип может быть перенесен на любое из нескольких аналитических устройств.
Подготовка образцов для TEM
Обработанный в ChipMill образец может быть помещен в систему фокусированного ионного пучка (FIB) для выборочного извлечения ламелей для трансмиссионной электронной микроскопии (TEM).
После последующей полировки с использованием системы подготовки образцов TEM Fischione Instruments, такой как Model 1040 NanoMill® или Model 1080 PicoMill®, можно получить атомарную структурную и химическую информацию о образце с помощью коррекции аберраций и TEM-анализа.
Процесс ChipMilling
Все компоненты системы размещены внутри камеры, которая откачивается безмасляной вакуумной системой.
Специальная образцовая платформа с движениями по осям X, Y, Z и вращением обеспечивает корректное позиционирование образца относительно различных компонентов системы. Автоматическое определение высоты образца устанавливает поверхность образца в оптимальную плоскость для фрезерования.
Конструкция камеры ChipMill позволяет ионному пучку проецироваться на поверхность образца под малым углом. Угол фрезерования определяется комбинацией контроля высоты образца и величины вертикального отклонения ионного пучка. Диапазон угла фрезерования составляет от 0 до 10°.
Во время фрезерования образец непрерывно вращается, чтобы минимизировать неравномерное снятие материала различных элементов чипа, которые испаряются с разной скоростью. Как правило, более твердые материалы фрезеруются медленнее, а более мягкие – быстрее, что приводит к эффекту «занавеса» (curtaining). Вращение образца нормализует фрезерование и обеспечивает плоскую поверхность.
Обратная связь от поверхности образца управляет сканированием ионного пучка
Во время фрезерования схема сканирования ионного пучка контролируется продвинутым алгоритмом, который обрабатывает данные с различных детекторов:
- Оптическая камера фиксирует интерференционные полосы для определения схемы удаления материала.
- Взаимодействие электронного пучка с образцом генерирует вторичные электроны, которые улавливаются детектором Everhart-Thornley SED.
- Обратно рассеянные электроны возникают в результате упругого рассеяния электронов первичного пучка на поверхности образца; они помогают различать слои внутри устройства.
- Рентгеновское излучение, испускаемое образцом при облучении электронным пучком, фиксируется системой EDS, предоставляющей информацию о элементном составе.
- Ионы, испускаемые во время фрезерования, анализируются методом SIMS, который чувствителен к поверхности и позволяет определить, какой слой открыт. Это полезно для установления, является ли слой металлом, оксидом или нитридом.
Искусственный интеллект ChipMill
ChipMill оснащен процессом искусственного интеллекта (AI), который включает контур обратной связи для корректировки параметров фрезерования ионным пучком в реальном времени. ChipMill получает и анализирует данные от различных детекторов, чтобы оценить как плоскостность поверхности, так и химический состав отдельных слоев устройства.
Профили глубины рассчитываются алгоритмом управления ионным пучком, который автоматически регулирует схему растрового сканирования ионного пучка, включая время выдержки и плотность тока в каждой точке при перемещении по делайерированной области. Этот метод непрерывной обратной связи обеспечивает получение высоко-плоской поверхности образца.
Программирование системы
ChipMill программируется через стандартный компьютерный интерфейс. Условия работы системы программируются и отображаются на выделенном мониторе. Сенсорный экран на борту, расположенный рядом с загрузочной камерой (load lock), облегчает замену образцов. Элементы управления пользователем могут быть размещены либо непосредственно рядом с ChipMill, либо в отдельной комнате.
Определение конечной точки (End-pointing)
Существует несколько методов определения конечной точки, один из которых основан на времени. Однако для эффективного использования временного метода конечной точки необходимо хорошо понимать как толщину слоя, так и скорость фрезерования.
Пионерская методика ChipMill для определения конечной точки основывается на получении изображений и аналитических данных:
- Ионное фрезерование открывает иерархическую информацию о цепях каждого слоя.
- SEM (сканирующий электронный микроскоп) работает при заданном ускоряющем напряжении, чтобы получить информацию о поверхности обрабатываемого слоя.
- Ускоряющее напряжение электронного пучка SEM увеличивается для получения информации о слое под поверхностью.
- Данные сопоставляются с химическим составом, полученным системами EDS и SIMS, что обеспечивает точное управление конечной точкой.
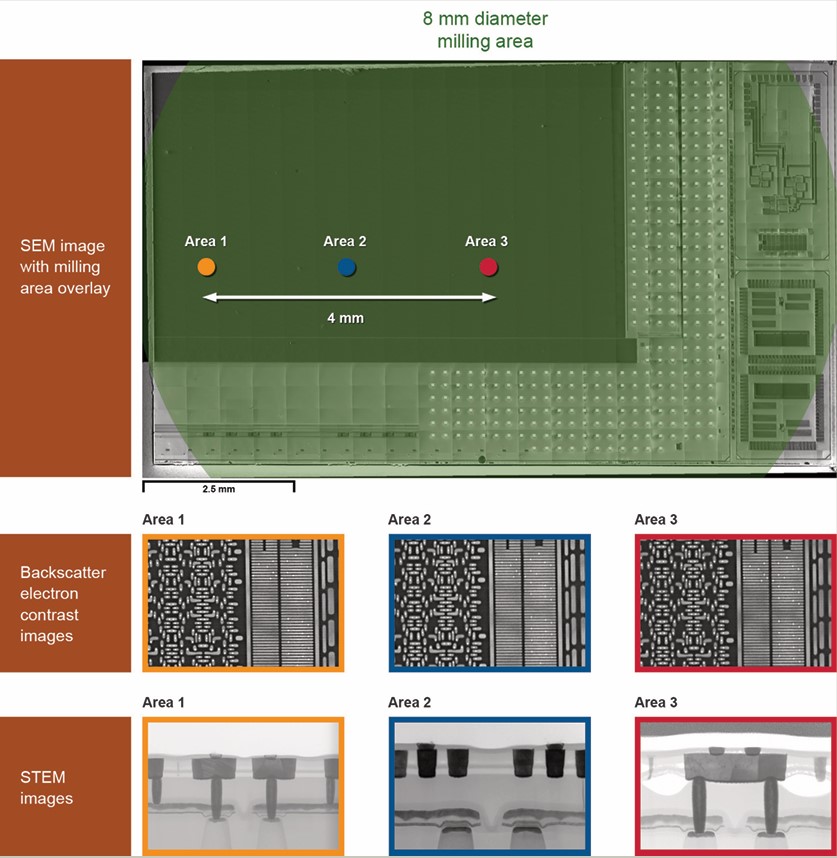
Однородность поверхности устройства после процесса делейринга
Для наблюдения после ChipMilling были выбраны три области чипа (Область 1, Область 2 и Область 3, верхний ряд); наблюдаемые области расположены на расстоянии 2 мм друг от друга. Показаны изображения поверхности образца с контрастом обратного рассеяния электронов (BSE, средний ряд) для каждой области наблюдения. Также приведены соответствующие изображения методом сканирующей трансмиссионной электронной микроскопии (STEM, нижний ряд).
Разница между тремя наблюдаемыми областями на протяжении 8 мм составляет менее 50 нм.
Обслуживание и сервис
ChipMill подпадает под одну из опций сервисного контракта компании Fischione Instruments. Для ускорения обслуживания ChipMill оснащён возможностью удалённой диагностики.


 Узбекистан
Узбекистан





